打線製程 Wire Bonding
打線製程是一種常見的半導體封裝技術,用於連接晶片與封裝基板或其他電子元件,以建立電子元件之間的電氣連接。這個過程通常在集成電路(ICs)、半導體封裝、半導體相關測試以及其他電子元件的製造過程中使用
目前上通電子提供的打線代工的線材種類,以(1)金線Au Wire、(2)鋁線Al wire為主力
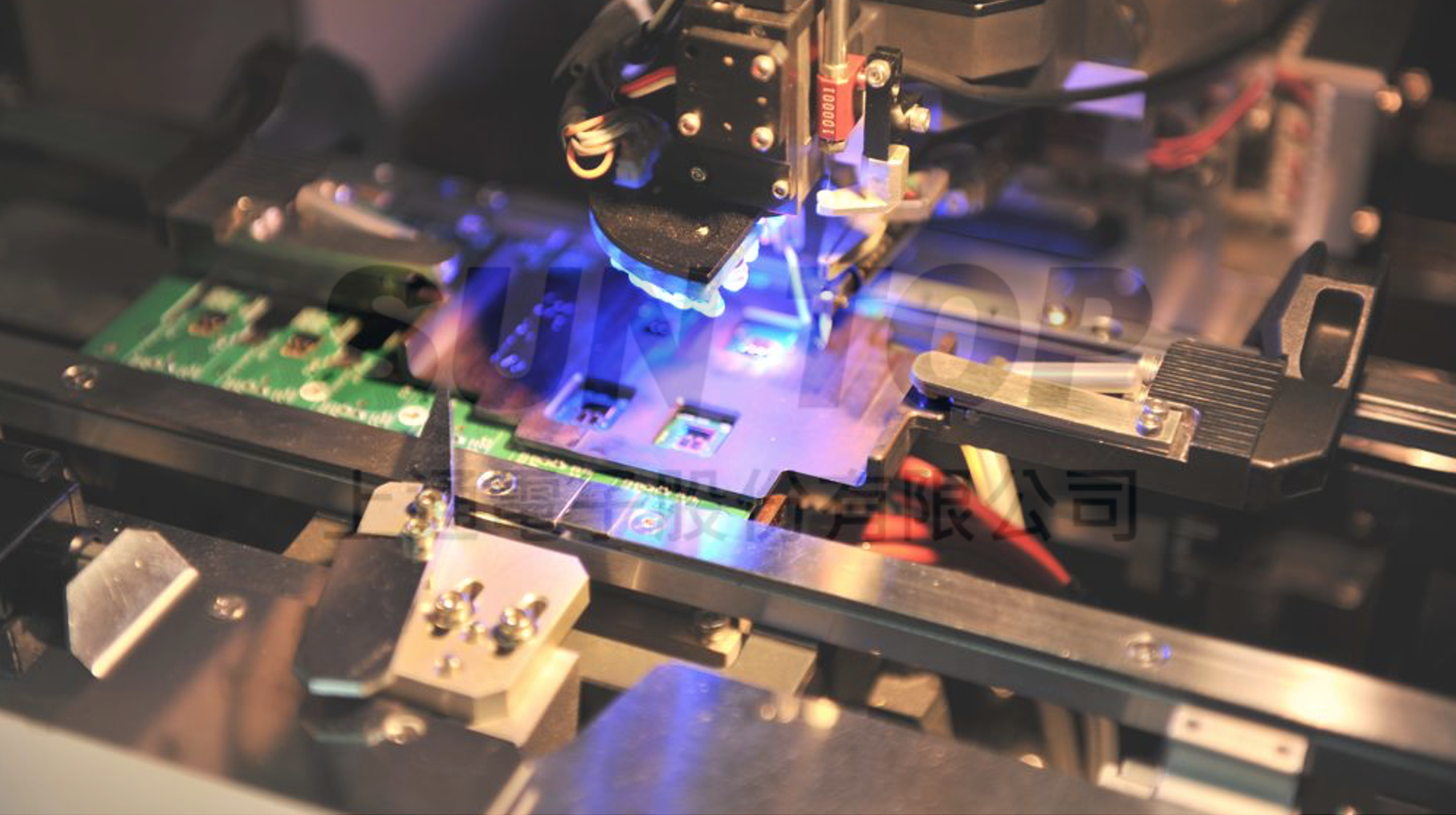
(1) 金線 Au wire bonding
| 項 目 | 上 通 電 子 打 線 能 力 |
| 線徑 | 0.6 ~ 1.2 mil ( 主力: 0.7、0.8、1.0mil) |
| X, Y軸重覆精度 | ±2.5µm |
| 最小焊點間距 | 35µm |
| 打線模式 | Ball bonding 超聲波球型焊接 |

(2) 鋁線 Al wire bonding
| 項 目 | 上 通 電 子 打 線 能 力 |
| 細線徑 | 0.8 ~ 2.0 mil ( 主力: 0.8、1.0、1.25mil) |
| 粗線徑 | 5.0 ~ 12mil (主力: 5.0、12mil) |
| X, Y軸重覆精度 | ±2.5µm |
| 打線模式 | Wedge bonding 楔型焊接 |
